ダイシング受託加工サービス
ガラス・石英・セラミック・サファイアなどの切削加工はお任せください。 当社ではダイシングテープ及びワックスを使用したダイシングなどお客様の条件に合う最適な加工方法をご提案いたします。
ダイシング加工とは
ダイヤモンドブレードを使用して、基板を長方形や正方形などの形状に切断する加工方法です。 当社では半導体ウエハーや光学ガラス部品、セラミック等の基板を0.5㎜~のサイズに加工することが可能です。
お求めの製品仕様に合わせて条件を設定いたします。 ダイシングテープの場合はコスト面で有利です。 ワックス等でのカットは外形寸法の精度追求や異形基板のダイシングに効果的です。
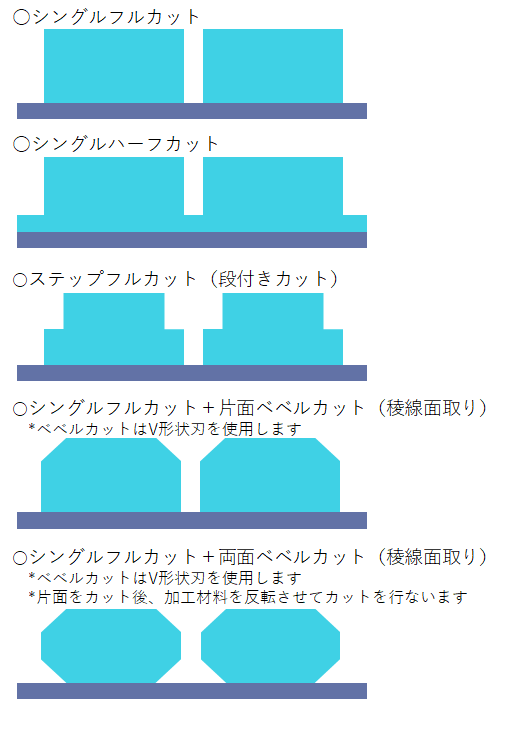
クリーンルームでのダイシング加工
当社では約40年培ってきた半導体のダイシング技術とノウハウの蓄積により、硬くて脆い材質から軟らかい材質まで、あらゆる難加工材料の切削が可能です。
対応可能な素材一覧
| 材質 | ワーク サイズ |
加工 サイズ |
寸法公差
|
最大 ワーク厚 |
加工レベル |
|---|---|---|---|---|---|
| シリコン系 | MAX φ8inch □154㎜ |
MIN □0.2㎜~ (多角,異形可) |
±0.010mm
|
3.0㎜程度 | 0.020mm未満 |
| ガラス系 (石英,サファイアなど) |
±0.050mm | 3.0㎜程度 | 0.100mm未満 | ||
| セラミック系 | ±0.050mm | 3.0㎜程度 | 0.050mm未満 | ||
| SiC,GaN | ±0.050mm | 1.0㎜程度 | 0.050mm未満 | ||
| 複合材 (ガラス+SiCなど) 他 |
±0.050mm | 2.0㎜程度 | 0.100mm未満 | ||
| その他,樹脂系材 など | ±0.050mm | 2.0㎜程度 | 0.100mm未満 |
※上記以外の材質、サイズにつきましてもご相談を承ります。
クリーンルーム環境

ダイシング加工装置

ダイシング加工の流れ
あらゆる難加工材料の切削が可能です
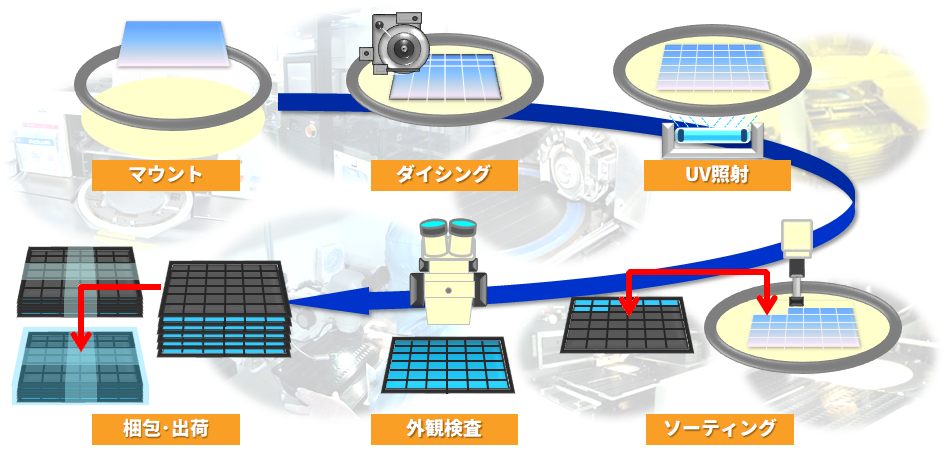
SiCのダイシング加工
SiC(炭化ケイ素)ウエハのダイシング加工実績は多数ございます。
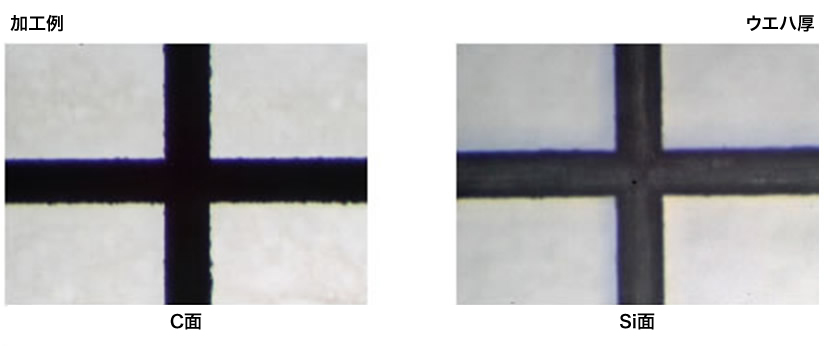
加工品質
チッピング:<20μm (Si面、C面)
加工可能サイズ
ウエハサイズ:2~6インチφ
ウエハ厚:~2.0mm
加工チップサイズ:1.0mm~
加工環境
クリーンルーム:設計値:Class10,000(実力:<1,000)
切削水 :比抵抗18MΩの純水をCO2バブラーにて0.7MΩに落として管理、使用
※テスト加工を承ります。 お気軽にご相談ください。
ダイシング加工事例
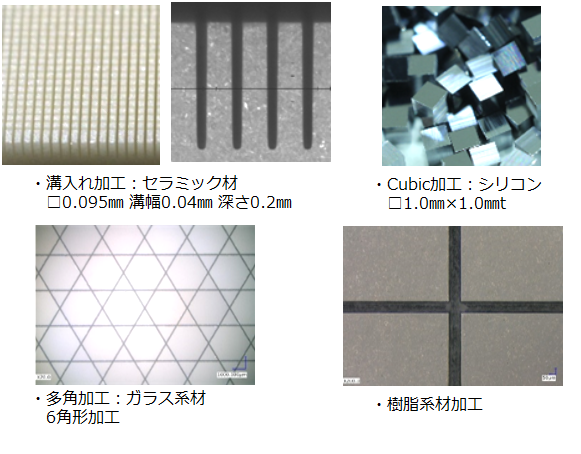
セラミックダイシング(切断)加工技術紹介
スライス加工
当社では、長年培ってきたダイシング加工技術を応用し、ガラスやセラミックなどの厚物製品の切削加工を行っております。
厚物基板の加工には最適なスライサーやダイサーで、最大厚み24mmまでの基板を加工することができます。
また加工精度を高めるため、WAXを使用した切削加工にもご対応します。 切削後の基板は超音波洗浄で徹底してWAXなどの残滓を除去。 安心の品質をご提供いたします。

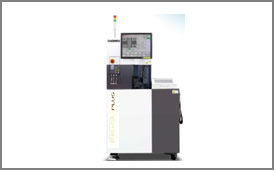


| 対応ワークサイズ | 角型ワーク | 90mmまで(ステージ改造により口200mmまで対応可) |
|---|---|---|
| 丸型ワーク | Ф4inchまで(ステージ改造によりФ8inchまで対応可) | |
| 最大切削厚み | 24mmまで(土台の基材を含む) | |
セラミック等のスライス~研磨~ダイシングまで、一貫でご対応いたします。
| 対応ワーク厚み | 100mmまで ※その他の厚みについてもご相談ください |
|---|
加工サンプル


加工フロー例
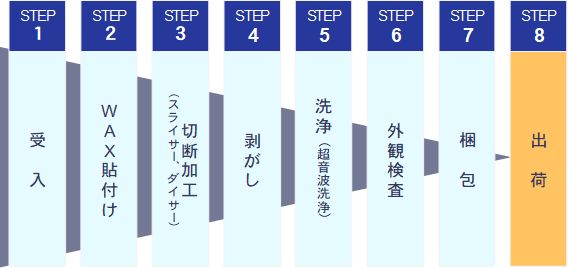
※切断工程ではスライサー/ダイサーの切断設備、及び材料の性質にあった加工条件や切断設備を選定し、加工作業をおこないます。1枚からの切断加工にも対応いたします。
